工学研究院 羽深等 教授と大学院工学府生の論文が Advances In Engineering のウェブサイトで紹介されました

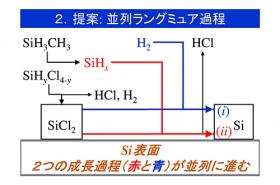

大学院工学研究院 羽深等 教授と大学院工学府博士前期課程の 2年生 渡部亨さん、修了生の山田彩未さん、齋藤あゆ美さん、桜井あゆみさん(指導教員:工学研究院 羽深等 教授)の共同研究内容が工学的評価の高い研究として認められました。
シリコンエピタキシャル薄膜成長のための表面反応過程を、従来の単独課程から複数の並列過程にすることに新規性と進歩性があり、これにより薄膜成長速度を 2倍程度に高速化することに成功しました。具体的には、従来用いられていたトリクロロシラン (SiHCl3) にシリコン水素化物を加えることにより実現しました。
Advances in Engineering は科学技術全般にわたる分野の投稿論文を精査し、特に優秀なものを選び定期的に紹介し、研究者や技術者の間で最新鋭の工学的研究に関する情報を共有するサービスを提供しています。
シリコンエピタキシャル薄膜成長のための表面反応過程を、従来の単独課程から複数の並列過程にすることに新規性と進歩性があり、これにより薄膜成長速度を 2倍程度に高速化することに成功しました。具体的には、従来用いられていたトリクロロシラン (SiHCl3) にシリコン水素化物を加えることにより実現しました。
Toru Watanabe, Ayami Yamada, Ayumi Saito, Ayumi Sakurai, Hitoshi Habuka. Parallel langmuir processes for silicon epitaxial growth in a SiHCl3-SiHx-H2 system. Materials Science in Semiconductor Processing 72 (2017) 134–138
Advances In Engineering( AIE )紹介記事
Advances in Engineering は科学技術全般にわたる分野の投稿論文を精査し、特に優秀なものを選び定期的に紹介し、研究者や技術者の間で最新鋭の工学的研究に関する情報を共有するサービスを提供しています。
(担当:工学研究院)





